
|
|
私の問題解決の考え方 第4章5<極薄シリコン酸化膜の厚さ>(9),(12),(13)シリコン(Si)酸化膜/シリコン構造の試料の分析をエスカ(ESCA; Electron Spectroscopy for Chemical Analysis)で試みて、いろいろなことを学べました。(9) 界面構造だけでなく、酸化膜の組成や化合状態の検討もできました。勿論、膜厚を求めることもできました。 これだけのことができたのは、次のようなことからです。 1.Siの酸化膜の組成と化合状態(化学シフト)および酸化膜とSiの界面状態について、できる限り信用できる方法(製品に使うSiの酸化法)で試料を作成し、できる限り注意深く詳細なエスカによる分析を行ないました。 2.さらに、Siの場合、酸化膜の厚さを測る光学的な方法(エリプソメーター)が当時既に確立されていて、この方法で全てのSi酸化膜の厚さを測定しました。 特に、これらの測定全てを、矛盾ないように解析し、私達がもっとも納得できる結論を導くことができました。 当初気づいていなかったのですが、やってみたら、組成や化合状態に相当する測定量が膜厚に依存していたのです。 ここでは、エリプソメーターで求めた膜厚を参考にして行なった、エスカによる膜厚の求め方を説明します。 私が中心になって手がけた多くの研究とは違い、IさんははSi酸化膜の膜厚だけでなく、組成や化合状態までも、定量的に(その値を)求めようとしました。(9) これは、分析の研究と言えます(私は、いろいろな特性との対応付けさえできればいいと思っていましたが)。 この研究のお陰で、とても貴重な知見が得られました。中でも、膜厚を求められることを示したのが特に大事であったと私は考えています。理由は、 1.まず、エスカだけで膜厚を求められるようにしたい。ということは、エスカで可能な、膜厚約10nm以下のSi酸化膜厚を求めたい(従来の、エリプソメーターによる測定には怪しいところがある)。 2.正確な膜厚が分からないと、組成や化合状態も求められない。 です。 理論的に、膜厚dは、膜が均質なら、エスカ測定で得られる、酸化したSiと酸化していないSi(Si基板)の強度(Isi-oとIsi)比を使って、 Isi-o/Isi = A[exp(d/0.7373/λsi-o) - 1] (1) の関係から求められます。ここで、Aは定数です。 そのためには、脱出深さλsi-oの値が必要です。しかし、その値としていろいろな値が得られていて、どの値を使っていいか分かりません。そこで、Si酸化膜の場合、膜厚がエリプソメーターで測れるので、(1)式が成り立つようなλsi-oの値を求めました。 Si酸化膜の場合、エリプソメーターで膜厚を測れますので、その膜厚を使って、脱出深さλsi-o求めようとしました。 そうすると、エリプソメーター膜厚をそのまま使ったのではうまく求められないのですが、その値を、各種膜厚において、同じ値(-0.35 nm)だけずらしてやることによって、λsi-oを求められました(=3.49 nm)。 そのようになるエスカの膜厚は、dELをエリプソメーターの膜厚とすると、図4.30に示すように、よい対応を示し、 ds = dEL - 0.35 nm になりました。 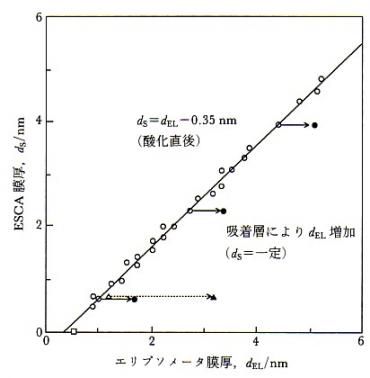 図4.30 エスカ(ESCA)の膜厚とエリプソメーターの膜厚の対応付け つまり、二つの膜厚は、勾配1の直線の関係になっています。これは、とてもうれしく、ありがたい結果でした。驚くべき結果とも言えます。エスカの膜厚が使えそうだということです。エリプソメーターの膜厚も大丈夫らしいと感じました(測定に注意をすればです)。 そのような仮定は何もしていないのに、こうなったのです。これは、両者の目盛りが合っていることを示しています。 この実験結果から、とても大事なことが分かってきました。エリプソメーターに関する心配の原因が分かってきたのです。図で、試料を空気中に一ヶ月放置すると、エリプソメーターの膜厚が大きくなってしまうという結果が得られました。酸化直後(15分以内に測定完)の膜厚(白丸○)が一ヵ月後に0.7nmぐらい大きくなって(黒丸●)います。 それに対して、エスカの膜厚dsの値には変化が見られないことから、真の酸化膜厚は変わっていないと考えられます。 さらに、有機汚染の激しい酸化膜では、エリプソメーターの膜厚が著しく変わっていることが図から分かります(黒三角▲)。 エスカでこの原因を調べると(図4.31参照)、空気中放置により、表面の吸着物(有機物)が増えることにより(推定)、炭素Cが時間とともに増えていました。また、エスカの酸素(O)の強度から求めた膜厚の若干増加したのは、水のような、酸素を含む吸着物が増加したと考えられます。  図4.31 エスカの膜厚と炭素C強度(吸着物)の空気中放置時間依存性 即ち、エリプソメーターの測定には、吸着物の影響が含まれるということを示せたのです。 [読者からのご指摘] 最新の高性能エリプソメーターを製造している(株)ユーレカの政尾克也社長から次のような書き込みをいただきました。 >図4.30と4.31ですが、エリプソメーターの測定結果にはモデルの設定がかかわってきます。この場合2層膜として計算すれば、吸着していく有機物の厚さと屈折率も同時に測定できるのでは?と思います。逆に1層膜として計算すると、純粋なSi酸化膜の屈折率とは違った値になるはずです。(Si酸化膜の膜厚が厚ければ相対的にこの効果は小さいでしょうが。) 今は非常に薄い酸化膜の屈折率も測定できていて、 heureka.co.jpのサイトには自然酸化膜の成長過程と屈折率などのデータがあります。(2008年04月05日 11時37分50秒) ☆私の答え 政尾 様 とても貴重なご指摘をありがとうございました。 これらの測定は30年以上前に行なわれたもので、元わが社の工場でも研究所でも、Si酸化膜一層であるという想定で、膜厚を求めていました。 エスカでは酸化膜の構造を考えたのに、エリプソメーターの方ではそれを怠っていたことについては反省しています。言い訳になりますが、エスカの測定が既に「余計な」(本業の仕事から考えると)ことでしたので、エリプソメーターのことをもっと深く考える余裕がなく、当時のやり方でしか測定しませんでした。 膜厚の説明に戻りましょう。 このようなことが分かったのは、良い試料を使って、注意深い実験を行なったからです。 エスカ測定も、エリプソメーター測定も試料作成直後に行なっています。ですから、表面の吸着物の量がほぼ一定という条件での測定ができました。 そのお陰で、図4.30のような、良い結果(白丸○)が得られたのです。このような注意を払わなかったら、このようなきれいな結果にはならなかったでしょう。 実際に、これらの試料は、大気中に放置すると、吸着物が増加して、エリプソメーターの膜厚は大きくなる傾向があります。図4.31の実験では、当初の膜厚1.3nmが、3.5 Ms(100万秒)(約40日)後、エリプソメーターの膜厚は2.4 nmになっていました。 なお、エスカで酸化膜厚を測定するのに、酸素(O)のピーク強度を使うことも考えられます。それがdoとして、図3.41に示してあります。この膜厚は,酸化直後はdsとほぼ同じですが、大気中放置で少し厚くなります(多分水分の吸着のため)。 もう一つ、界面層Tを酸化膜に含めること(膜厚dS+T)も考えられます。この場合は、酸化直後は、エリプソメーターの膜厚とほぼ同じになります。しかし、酸化膜の組成や化合状態の膜厚依存性を考えるときには、dsの方が適しています。 結論として、エスカの酸化膜厚にはdsを使うことにしました。 その結果、 1.酸素(O)と酸化したSiの強度比のds依存性から、シリコン酸化膜は薄いところでも二酸化シリコンになっている(厚いところでそれを仮定すると)。 2.帯電が膜厚に依存するとして、そのds依存性から、真の化学シフトが3.0 eV(SiO2)になると推定した。そうすると、界面層Tの化学シフト1.5 eVというのは、SiOのそれに相当すると考えられる(9),(11)。 という結論に達しました。 この結論が得られたのは、正しい膜厚dsを求めて、これらの検討に使えたからです。 3800字08/5/22 <化合状態は分かるか> 私達がシリコン酸化膜での検討を始めたのは、アルミニュウムにおいて、酸化膜が非常に薄くても、化学シフトが化合状態を表していない「疑い」があったからです。 この「疑い」がきっかけになって、私達の研究は、「実在」*表面(界面)の「評価手法」の確立と、さらに、十数年後には、エスカによる微量欠陥(電荷を持つ)の検出法の発見につながるものとなったのでした。 (*「空気、水、その他の汚染に触れた」表面(界面);表面(界面)科学で主として扱う清浄のものとは違う) また、エスカによる定量的な検討(組成とか膜厚の値を求めること)の難しさを思い知らされました。上記の「評価手法」にはこれらのことも加味されていて、実用的で、現実的な手法になっています。 さて、前置きはこのくらいにして、化学シフトの検討に入りましょう。 これまで、厚さ数nm以下のシリコン酸化膜の組成、膜厚や、下地(基板)シリコンとの界面の状態の検討をしてきました。それらの結果によると、酸化膜は、膜厚を変えても、均一なSiO2(二酸化シリコン)になっていると考えられました。 ところが、化合状態を示しているはずの化学シフト(シリコンと酸化シリコンのピーク位置の差)は、図4.32に示すように、一定な値になっていませんでした。  図4.32 化学シフトの膜厚依存性 まず、もう1回、なぜ化学シフトが現われるかを考えてみましょう。シリコン(Si)原子と酸素(O)原子が結合すると、SiからOへ電子が移り、Siは正電荷に、Oは負電荷になります。この状態でX線を照射し、電子を励起させると、外へ飛び出そうとするとき、正電荷を持つSiでは、負電荷の電子は後ろへ引っ張られるので、外に出たときの運動エネルギーがその(Oと結合した)分だけ小さくなります。一方、Oから放出される電子の運動エネルギーは大きくなります。 ですから、この電子移動の状況(化合状態)が変わる場合、酸化したSiとOのピークの間隔が変わるはずです。それを調べたのが図4.33です。 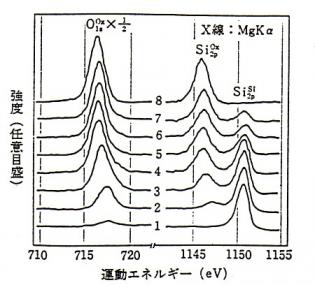 図4.33 各種膜厚の酸化膜を有するシリコンのOとSiのエスカ・スペクトル ここで、膜厚はエリプソメーターの厚さで、下から、0.6, 1.0, 1.5, 2.1, 3.0, 4.0, 4.9 と200 nmです。 この図で、 まず、Siのスペクトル(発生電子強度の運動エネルギー依存性)で、酸化したSiのピークは、酸化していないものより低エネルギー側にあります。これは予想通りですが、次に、酸化したSiの運動エネルギーが膜厚が増すとともに小さくなっています。これは、膜が厚くなる(酸化が進む)とともに、化合状態が変わっていくとも考えられます(実際は違います)。 もしそうであれば、Oの運動エネルギーが低い値から高い値に変化していく傾向があるはずです。 ところが、実際には、Oの運動エネルギーも膜厚とともに小さくなっていました。しかも、その変化は、それぞれの膜厚で、Siのそれと同じ方向に、ほぼ同じ値でした(平行移動)。 これは、これらの変化が化合状態以外の要因によるものであることを示唆しています。さらに、ほぼ同じ値、同じ方向に変化するということは試料表面の電位が変化していると考えれば説明できるのです。 一方、X線の照射時間や強度によっても、化学シフトの値が変わることも分かりました。(11) これらの結果は、X線照射の影響で、酸化膜と下地のシリコンの帯電状態の違いにより、電位差が生じて、それにより、化学シフトの値が変化してしまったことを示唆しています。 つまり、測定すること(そのために照射するX線)により、試料の状態が変わってしまう(測定中は)ということです。ですから、求めた化学シフトは真の値とは違うものになってしまうのです。 図4.34には、化学シフトのX線照射時間依存性を示します。 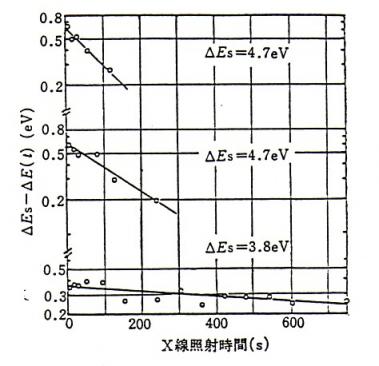 図4.34 シリコン酸化膜の化学シフトのX線照射時間依存性 (ΔEs: 定常状態での化学シフト、ΔE(t): 時間tでの化学シフト、それぞれの結果の試料の酸化膜厚は下から1,3,4 nm) アルミニュウム酸化膜の場合と同様に、帯電の影響が認められています。ここで、定常状態とは、X線を十分長い時間照射して、化学シフトの値が一定になった状態のことです。 X線照射の影響を取り除くには、時間をゼロに近づければいいのですが、実験では、化学シフトの測定に少なくとも5秒程度(当時)はかかってしまい、それ以下の時間での依存性は分かりませんでした。 そして、その、測定できた範囲だけのデータからは、真の値は、3.4から4.0eV 以下であろうと推定されました。 次に、X線強度依存性の結果をお目にかけます。 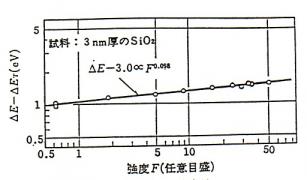 図4.35 化学シフトのX線強度依存性[縦軸は、定常状態の化学シフト(図4.34のΔEs)から真の値ΔETを引いたものです) 測定に用いているX線強度の領域では、化学シフトの値はあまり変化しませんが、強度を極端に弱くすると、変化が見られるようになります。 ここでは、強度をFとすると、 ΔE - ΔET ∝ F^n (Fのn乗) の関係になっていると仮定して(11)、真の値を求めました(理論的なことは不明)。即ち、縦軸も横軸も対数目盛りにしたときに、直線関係が得られるようなΔETとnの値を求めました。図では、真の値を3.0eV、nを0.098としたときに得られた直線関係が示してあります。そして、他の膜厚でも、真の化学シフトの値が同じ値になりました。 最後に化学シフトの膜厚依存性について考えてみましょう。 図4.32の膜厚依存性が帯電によるものだと考えて、それを引き起こす電荷分布による, 酸化膜表面の電位変化を求めようとしました。 その分布をexp(-kx)に比例する(x は酸化膜/Si界面からの距離で、kは定数)ものであると仮定するとy)、化学シフトΔEは、真の値をΔET、膜厚をdとしたとき、 ΔE = ΔET + A[1-kd・exp(-kd)-exp(-kd)] と計算できます。ここで、右辺の第二項が帯電による表面電位変化の影響です。 図の中の実線の曲線は、上式で、 ΔET = 3.0 eV, A = 1.75 eV, 1/k = 0.5 nm とした場合のものです。 即ち、真の化学シフトが3.0eVだと、私達が測定した化学シフトの膜厚依存性は説明できるのです。 実際に、私達のデータではありませんが、膜厚がとても小さい領域での化学シフトの測定値(△印)は3.0eVに近い値になっています。 なお、この図で、膜厚が大きい(1nm以上の)ところでは測定者依存性(●や△印)があることが分かります。これは装置による測定条件(同じ状態で測定できていない)の違いによると考えられます。 さらに、私達の別の測定で、厚さ100nmの酸化膜のあるシリコンの上に導電性のあるTiN(窒化チタン;厚さ100nm)膜がある試料の表面をダイヤモンドの針でひっかいて、シリコンとシリコン酸化膜を表面の一部では露出させるが、大部分はTiNで覆われている状態では、化学シフトの値が3.0eVになりました。 以上の結果(X線照射時間、強度と酸化膜厚依存性等)より、真の化学シフトの値は3.0±0.2eVであるという結論になりました。 そして、この値は、これまでの検討から、SiO2の化学シフトであると結論付けました。この値が、界面層(SiOの化合状態)の化学シフトの約2倍になっていることとも話が合います。 つまり、帯電の補正をすることによって、Si酸化膜の化学シフト(化合状態)が求められたことになります。 しかし、一般的には、これまで行なってきた分析とデータ処理は日常の使用には手間がかかりすぎます(次項参照)。 では、どうしたらいいのでしょうか。 図4.33の説明で指摘したように、酸化したSiとOは帯電により同じ変化をしますので、酸化SiとOのピーク位置の差をΔεとすると、この値は、帯電状態が変わっても、同じ値、 Δε = 429.5±0.1 eV になります。これがSiO2 の値で、SiOのΔεは430.9 eVなります。即ち、Δεを化合状態の評価に使えます。 <終わりに> 私達は、相当な苦労をして、シリコン基板上に薄いシリコン酸化膜のある試料のエスカ(ESCA: Electron Spectroscopy for Chemical Analysis)分析を行ないました。 「まんずやってみれ!」の精神で、いきなり難しい測定に挑戦しました。 そして、これら酸化膜の組成、酸化膜とシリコン基板の界面構造、酸化膜厚と、酸化膜の化合状態について、かなりの知見を得ることができました。 界面構造を調べるためには、酸化膜の厚さを変えていったり、同じ酸化膜厚で、電子の放出角を変えてエスカ分析を行なう手法も用いました。(10) しかし、シリコン酸化膜の化合状態を求めるには、X線照射の影響を取り除くのに苦労しました。 エスカの測定を実際に行なってみると、知りたい上記の情報をそのまま測定できるということはありませんでした。正に、「隔靴掻痒」の状態でした。いろいろ仮定したり、他の測定結果(自分達の)を参考にし、データ処理を行なって、やっと何とか答にたどり着くというような状態でした。 それでも何とか答が得られたのは、シリコンの場合、確立した酸化技術があったお陰で良い試料が作れたことと、酸化膜の厚さをエリプソメーターで測ることもできたからです。さらに、Si酸化膜では、酸化膜が膜厚を変えてもSiO2であったのです。それに、私たちに、エスカをぜひ使いこなしたいという強い気持があったからです。 これらの検討は、シリコン酸化膜だからできたことで、一般には、難しいと言わざるを得ません。それに、できたとしても、非常に手間がかかる測定とデータ処理になると予想されます。従って、一般的な半導体関係の問題への応用は無理でしょう。 さらに、私の仕事は、分析ではなく、半導体製造技術開発に関する問題を解決することでした。そのとき、やっていることの良し悪しの判定や、悪かった場合の対策に必要な「情報」(できる限り定量的な)が欲しかったのです。 つまり、組成、膜厚、化合状態そのものが必ずしも必要ではなかったのです。これらの量に代わる、これらに関係のある量でもよかったのです。 実際の問題での経験から、多くの場合、エスカで測定するピークの強度比とか、ピークの位置の差が使えたのです。即ち、相対的な量で、組成、膜厚や化合状態の違いを表す量(数)でよかったのです。 シリコン酸化膜に関する測定について説明しましょう。 まず、組成については、酸素(O)と酸化したシリコン(Si)の強度比が使えます。但し、既に述べたように、この強度比は、膜厚10nm程度以下では膜厚によっても変わってしまうので、同じ膜厚で比較しなければなりません。この程度以上の膜厚なら、強度比で組成の比較ができます。(なお、より正確な比較のためには、吸着層の炭素(C)の量が同じ状態で比較したいです。) 次に、酸化膜厚については、酸化したシリコンと酸化していないシリコン(基板の)のピーク強度(高さ)比が使えます。特に、シリコン酸化膜の場合はエリプソメーターによる膜厚測定のデータがあるので、この強度比から直ちに酸化膜厚を求められます(私はこれらの関係をグラフにして持っていました)。 既に、アルミニュウム酸化膜の場合には、膜厚そのものは求められませんでしたが、この強度比(実際には、酸化していないアルミニュウムと酸化したアルミニュウムのピーク強度比を「表面清浄度」と定義して)を使っていました。この量により、金線熱圧着性(接合性)に与えるアルミニュウム酸化膜の影響を定量的に表すことができました。 最後に、シリコン酸化膜の化合状態については、酸化したシリコンと酸素のピーク位置の差を使いました。具体的には、Si2p(酸化)電子とO1s電子のピーク位置の差を取ると、帯電の影響はほとんど除去されて、この差の値が、酸化膜がSiO2なら、私の装置では、429.5eVになっていました。この値からずれている場合には、化合状態の違いが疑われました。(上述の2pとか1sというのは、それぞれ、SiとOの電子の種類(準位)を示しています。) なお、界面分析の手法としては、上にある材料の厚さを増やしながら、あるいは、減らしながら、段階、段階での各量の測定や、電子が放出される角度を変えて(膜厚変化に相当)の測定などが考えられます。後者の手法は、SiO2/Si界面構造の検討でも使っています。(10) 以上の検討により、エスカの実力を知ることができたとともに、エスカ測定の練習もできました。これにより、これからエスカをますます役に立てられると感じましたが、大きな欠点も明らかになりました。 まず、既に述べたように、X線照射の影響です。絶縁体では(後に半導体でも影響が認められましたが)、X線照射下では試料が変わってしまうとも言えます。 それから、半導体素子の特性関係の材料評価では、電気特性の関係のある、微量の欠陥や不純物(濃度として1万分の1以下)の検出が必要になるのですが、エスカの感度が足りないのです。エスカでは強度比として測れる最低の値は約千分の1ですので、微量分析には向いているといえません。検出感度が足らないのです。 他の分析手法に頼る(といってなかなかありません)か、今後、エスカでなにか新しい手法を考え出す必要があります。(そして、実際に、10数年後になりますが、帯電の測定により、ごく微量欠陥の検出が可能であることを示しました。)(15)-(18) 4.8 まとめ 子供の頃から、会社に入ってから数年までの間の、私の、問題解決に対する考え方について思い出して、まとめました。但し、そのときには、私の考え方を理解していませんでしたが、なんとなく同じような考え方で各種問題に対処していました。 それらは、 「まんずやってみれ!」(まず解決に着手すること)と 「チェック機能」(やっていることの良し悪しの判断法と悪い場合の対策を探す) ことでした。 会社に入ってからは、半導体関係の製品製造プロセス技術開発の研究を始めましたが、それまでの試行錯誤による開発のやり方(会社のやり方)だけでなく、頭を使ったやり方にするために、材料表面(界面)分析技術の開発にも同時に着手しました。ここでは、これらの研究がほぼ軌道に乗るまでの研究の考え方を振り返ってみました。 当時は全く意識していなかったのですが、入社以前の私の問題解決の考え方を、会社の問題にも適用していました。 会社の問題も、表面(界面)分析の研究も、私には未経験のもので、今になって考えると、ずい分無謀なことをやったものだと思います。 しかし、それまでの私の人生では、分からないことやできないと思うようなことをやらなければならないことが多かったので、未経験のことでも、それほど怖いと思いませんでした。 それどころか、会社に入って気づいたことは、 入社前に、材料表面(界面)の研究に興味を抱き始めていたことと、 会社の問題を解決しようとすると、表面(界面)に起因する問題が多い ということでした。 そのお陰で、いろいろ苦労もありましたが、次第に、研究に面白さを感じるようにもなっていました。これは、それまで、将来のことをあまり考えないで、いい加減に暮らしてきた、熱しやすく冷めやすい私にとって驚くべきことでした。 そして、会社に入って始めた研究で、プロセス技術開発の研究で、それを助けるために、表面(界面)の研究を立ち上げたのでした。 計12000字 08/12/14 4.9 大事な追加・・・「分からない」というのも証拠の一つ これは、実験後30年後に気づいたことで、「思ったような結果が得られなかった」という結果についてです。つまり、「分からない」という結果は、実は、酸化膜の中の酸素の化合状態についての重要な証拠でした。 シリコン上の薄いシリコン酸化膜をエスカで測定して、酸化したシリコンの化合状態と, エスカによるシリコンのピーク(測定結果)との関係を詳細に調べました。その結果から、SiO2とSiOの化合状態のシリコンがありそうだということに気づいたのでした。 一方、酸素の測定も行なったのですが、2種類の酸素があるとは言えませんでした。 その結果、私達の論文には、シリコンについての結果は詳細に述べたのですが、酸素の結果(ピークの形から2種類の酸素があるとは言えないという;酸素については、Si-O-Siという結合の仕方しかないと考えられる)には触れませんでした。つまり、分かったことは書いたのですが、分からなかった(見分けられなかった)ことは説明に使いませんでした。 使わなかったことにより結論が変わらなかったからよかったものの、これは反省することです。 参考文献 1)岩田誠一:「半導体プロセスにおける密着性」(薄膜の力学的特性評価技術、第3編、第2章)、リアライズ社、pp.448-479(1992) 2)岩田誠一、石坂彰利、山本博司:「Al蒸着膜へのAu線熱圧着性に及ぼすAl酸化被膜の影響」日本金属学会誌、45(1981)、603.. 3)S. Iwata, A. Ishizaka, and H. Yamamoto:"Corrosion test for metallization for plastic-encapsulated IC's," J. Electrochem. Soc., 126(1), (1979), 110-114. 4)岩田誠一:「LSI用電極・配線材料の腐食」、防食技術、35(1986), 656-661. 5)岩田誠一:「ULSIにおける腐食の問題」、材料と環境、40(1991), 336-342. 6)岩田誠一:「各種イオンを含む溶液中でのAuマイグレーション」、日本金属学会誌、45(4),(1981), 446-447. 7)岩田誠一、「希薄Clイオン溶液中におけるAl蒸着膜の腐食」、日本金属学会秋期大会一般講演概要、(1981)、341. 8)岩田誠一、石坂彰利:「ESCAで測定する絶縁薄膜の化学シフトに対する疑問」日本金属学会誌、42(1978), 1020-1021. 9)A. Ishizaka, S. Iwata, and Y. Kamigaki: “Si/SiO2 Interface Characterization by ESCA “, Surf. Sci., 84(1979), 355-374. 10) A. Ishizaka and S. Iwata: "Si-SiO2 Interface Characterization from Angular Dependence of X-ray Photoelectron Spectra," Appl. Phys. Lett., 36(1980), 71-73. 11)岩田誠一、石坂彰利:“ESCAで測定されるSi酸化膜の化学シフト”、日本金属学会誌、43(1979), 380-387; “X線照射による絶縁薄膜の帯電”、同誌、43(1979), 388-392. 12)S.Iwata: “Refractory Metal/SiO2/Si Interface and Device Characteristics”, SEMI Osaka Seminar, (1989), pp. 91-103. 13)S. Iwata and A. Ishizaka: “Thickness Measurement of Ultra-thin Si Oxide Films by ESCA”, Mat. Trans. JIM, 33(1992), 675-682.(岩田誠一:「ESCAによる極薄シリコン酸化膜の厚さの測定」、日本金属学会会報、30(7),625-632.) 14)岩田誠一、大路譲、石坂彰利:“ESCAによるSiO2/Si中の電荷の検出”、日本金属学会誌、56(1992), 863-864. 15)S.Iwata and A. Ishizaka: “Electron Spectroscopic Analysis of SiO2/Si System and Correlation with MOS Characteristics”, J. Appl. Phys. (Appl. Phys. Rev.), 79(1996), 6653-6713. 16)岩田誠一、山本直樹、矢野史子:“ESCAによるSiO2/Si内の電子トラップ、正孔トラップの検出”、日本金属学会誌、60(1996), 469-475. 17)岩田誠一、大路譲、石坂彰利:“Si上極薄SiO2膜帯電のX線照射時間依存性”、60(1996), 1192-1199. 18)岩田誠一: 「ESCAによるシリコン酸化膜内の微量不純物や欠陥の検出」、日本表面科学会誌、19(1998)、9-13. 19)岩田誠一:「ESCAによう半導体界面の評価」。第20回半導体専門講習会、(1982)、107. 「半導体研究」、第20巻、6章、工業調査会、(1983)。 12500字 08/12/14 ジャンル別一覧
人気のクチコミテーマ
|
||